인텔은 오는 2030년 이후까지 무어의 법칙이 건재할 것으로 전망했다. 업계 최초로 유리 플래터 위에 트랜지스터 집적이 가능해지는 시점이다. 기존 유기 기판 대비 유리는 매우 낮은 평탄도, 더 나은 열적(thermal) 및 기계적 안정성과 같은 특성을 보장한다.
밀도 향상에 유리한 특성은 AI와 같은 데이터 집약적인 워크로드용 고밀도 고성능 칩 패키지 구현에 이점을 발휘할 수 있다. 구체적으로 2025년 이후 2030년 이내 시점에 완전한 유리 기판을 활용한 반도체가 출시된다.
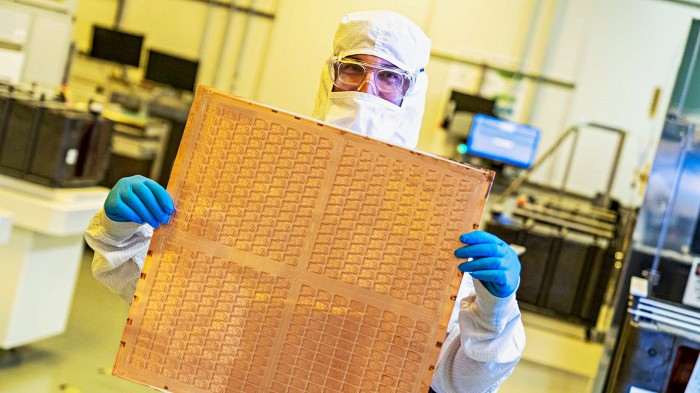

기존 유기 재료 실리콘 패키지 제조 공정은 트랜지스터 확장에 한계를 드러내고 있다. 더 낮은 전력효율성 및 수축과 뒤틀림이 문제다. 현 반도체 제조 환경은 여러 개의 칩렛을 하나의 패키지 내에 구현하고 있는데 이 기술은 패키지 기판의 신호 속도, 전원 공급, 설계 규칙 및 안정성이 생산 수율과 밀접하다.
유리 기판을 활용하면 더 많은 트랜지스터를 패키지 내에 집적할 때 우수한 기계적, 물리적, 광학적 특성을 보장한다. 더 나은 확장성도 가능해 큰 시스템-인-패키지로 불리는 칩렛의 고도화에 유리하다. 단일 패키지 내에서 더 많은 타일(혹은 칩렛)을 배치하면서 낮은 TCO까지 보장한다.
유리 기판은 고온에 강하며, 패턴 왜곡 발생률도 50% 낮다. 또한, 평탄도까지 우수해 리소그래피 초점 심도를 정교화 시킬 수 있으며, 촘촘한 레이어 간 인터커넥트 오버레이에 필요한 구조적 안정성까지 제공한다. 실제 유리 기판에서는 인터커넥트 밀도가 10배 이상 향상된다. 유리가 가진 특성을 활용하면 초대형 폼팩터 패키지도 제작할 수 있다.
고온 내구성은 전원 공급 및 신호 라우팅에도 유리하기에 유리 내에 인덕터와 캐패시터를 더 높은 온도까지 구동시킬 수 있다. 관련 업계는 오는 2030년까지 단일 패키지 내에서 1조 개 트랜지스터 집적 시도가 구현될 것으로 전망했다.
인텔은 유기 기판의 대체재로서의 유리 기판을 지목해왔다. 지난 1990년대 세라믹 패키지에서 유기 패키지로 전환을 주도했으며, 할로겐(halogen)과 무연 패키지를 최초로 선보것에 이어 고급 임베디드 다이 패키징 기술로 활성 3D 집적 기술도 구현했다.
By 김현동 에디터 Hyundong.Kim@weeklypost.kr
〈저작권자ⓒ 위클리포스트, 무단전재 및 재배포 금지〉


